GPU散热革命:NVIDIA微通道液冷板(MLCP)技术深度解析
图:采用液冷的Blackwell 系统

由于英伟达AI新平台Rubin与下一代Feynman平台功耗或高达2000W以上,现有散热方案无法应对。英伟达也不满足现有的液冷方案,要求供应商开发全新“微通道水冷板(MLCP)”技术。
MLCP以微米级通道把冷却液带到裸die附近,整合水冷板与封装盖、取消 TIM,散热效率远胜传统水冷。在AI服务器功耗上看2,000–3,000W的新常态下,MLCP被视为「冷革命3.0」关键解方。
一、技术概述:当AI 芯片遇上散热极限
1、什么是MLCP?
定义:MLCP 在封装/芯片结构中直接刻蚀微米级水道,将冷却液带到裸die附近,缩短热路径并移除传统需涂布的导热界面材料TIM,大幅提高散热效率。
为何现在:新一代AI/HPC平台单卡TDP传出高达2,000–3,000W,传统水冷难以因应,MLCP成为高功耗产品的候选标准。

2、技术背景:从实验室到 AI 芯片
理论奠基:1981 年,斯坦福大学学者首次提出微通道散热概念,展示了 800W/cm² 的惊人散热能力
现实需求:NVIDIA Rubin 等下一代 AI 芯片功耗突破 2000W,相当于把空调的发热量压缩到芯片大小
3、与风冷、传统液冷的区别

核心异差:
传统冷板水道宽约1–3mm,多贴合于封装盖外侧,经 TIM 导热后再带走热量。
MLCP 则在封装盖/中介结构甚至芯片附近刻蚀微米级通道,让冷却液更靠近热源,热阻链缩短、接触面积增加,同时可取消或大幅减少TIM。
二、技术原理:微通道的魔法如何实现
1、核心工作机制
MLCP 的散热效能源于三大物理效应的完美结合:
极大比表面积:微通道提供巨大的热交换面积,轻松应对 2000W 热功耗和 1kW/cm² 热流密度;
强迫对流效应:水泵驱动冷却液高速流动(流速达数米 / 秒),持续带走热量;
薄热边界层:微尺度流动显著降低热阻,强化换热过程。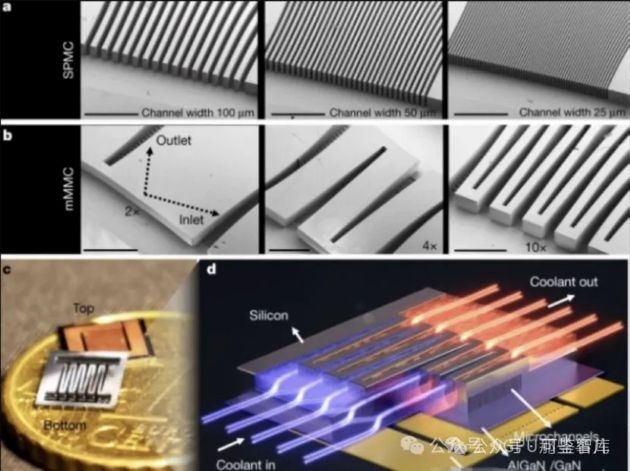
2、关键效果
晶片结温大幅下降,ΔT与热阻R_th降低。
在相同流量下可获得更高散热通量; 或在相同散热下允许更低流量与泵浦功耗。
对极端热点(如VRAM/HBM 边缘、chiplet 热斑)具有更高处理弹性。
3、材料与制造的科技突破
1)选择高导热材料
MLCP 通常采用铝合金 6061、纯铜等高导热率材料作为基板。铜的热导率可达 400W/m・K,是理想的选择,但其高反射率对传统激光加工提出挑战。
新兴的高导热金属基板(热导率400W/m・K)和纳米碳涂层材料(热流密度达 800W/cm²)也在被评估。
2)精密制造工艺
蚀刻技术:能够制造出高精度的微通道,但成本高昂,加工速度较慢。
金属3D 打印:可实现复杂结构的一体化制造,避免传统钎焊或组装带来的泄漏点。
微挤压技术:微通道挤压模具技术(流道≤100μm),能够高效生产微通道结构。
冲压技术:成本较低,但对于微通道尺寸和形状的限制较大。
三、导入门槛及工程挑战
1、微通道制程与可靠度。 微细通道加工、表面处理与接合强度,需兼顾抗腐蚀与长期渗漏风险。
2、封装整合。 与 IHS/lid/interposer 的机构整合、公差与翘曲控制,以及与压框/载板兼容。与传统冷板不同,MLCP需要跨越芯片设计、芯片封装、冷板制造等多个流程,需要多家企业一同推动。
3、流体与系统设计。 微通道压降大,需在泵功与散热效益间最佳化; 气泡管理与污染控制影响寿命。
4、良率与验证周期。 初期可能面临热流不均、疲劳寿命与热循环可靠度问题,系统级验证时间长。
四、市场应用及市场规模
1、应用场景
AI 服务器/HPC: 新平台功耗跃升,集群密度与能源效率目标推动液冷标准化; MLCP 直接降低芯片结温,减少降频与停机风险。
数据中心基建: MLCP 有助于降低机柜层级 PUE,在相同算力下降低供冷负荷; 但需搭配二次回路、汇流排、机柜级 manifold 与 CDU。
CPU/GPU/加速卡: 对chiplet 与 HBM 堆叠等热斑分布复杂的封装更具效益。
2、产业进度
需求端:英伟达 Rubin 平台预计 2026 年下半年导入 MLCP,Feynman 平台将全面适配,后续高功耗 GPU 均将以 MLCP 为核心散热方案。
供给端:台湾 “散热三雄”(AVC、Auras、Cooler Master)已率先向英伟达送样,其中 Cooler Master 作为 GB300 冷板的最大供应商(市场份额超 55%),有望率先突破量产;全球头部厂商如 Boyd(英伟达长期合作伙伴)、Mikros(热流密度 1kW/cm²)、JetCool(支持 3000W TDP)也在加速技术迭代。
3、市场规模预测:
代表产品:NVIDIA Rubin/Feynman、AMD MI300、华为昇腾
价值量:单机柜超40万元(传统冷板仅8 万元)
时间表:预计2026 年 NVIDIA Rubin 大规模导入 MLCP
2027 年全球 MLCP 市场规模:突破千亿元
4、成本与 TCO 思考
单价高: 市场估MLCP为传统水冷板3–5倍,甚至5–7倍。
系统层折衷: 若MLCP使结温大降、允许更高功耗或更高频率,或降低整柜供冷成本,整体TCO仍可能下降。
扩产与良率学习曲线,将决定未来单位成本下滑速度。
五、未来趋势:散热技术的星辰大海
1、技术演进方向
1)精度革命:从微米级向纳米级进军
台积电探索:芯片表面直接激光雕刻微通道
2)功能融合:散热+传感+供电一体化
嵌入式光纤传感器实时监测
微控制阀实现动态流量调节
2、技术融合的无限可能
1)分级散热系统:
2)混合技术方案:
微通道+相变液冷:效率提升 3-5 倍
MLCP+热电冷却:未来可能实现低于环境温度的冷却
3、产业化成熟路径
标准化进程:接口、尺寸、连接器标准化
成本下降预期:3-5 年内制造成本预计下降 30%-50% 来源
平台声明:该文观点仅代表作者本人,001can.com 信息发布平台 仅提供信息存储空间服务。










